Solderon™BP TS 6000锡镀银化学是一种高性能的无铅替代品,可针对今天的微观焊料凸块电镀应用优化,例如用于2.5D和3D IC包装技术的Cu柱和微凸块。下一代配方为倒装芯片封装和互连提供了行业领先的电镀速率和最大流程灵活性(图1)。新型化学功能采用增强的电镀性能,浴缸稳定性和易用性,从而实现了该行业最宽的过程窗口,具有最强大的流程灵活性和竞争性所有权(COO)。
该配方镀层速度可达2 ~ 9+µm/min。该配方中Ag成分的可调特性使其适合于多种应用,并消除了改变化学成分以满足不同加工要求的需要。它的化学性能足够强大,可以用于碰撞和覆盖广泛的图形晶圆,并且不受特定光刻胶的限制(图2)。它在多种晶圆类型中展示了回流芯片(Wid)凸起厚度均匀性<5%,这表明其适用于大批量生产(图3.)。此外,在回流后,它是自由的宏观和微无效,以提高产量和可靠性(图4.和5.)。
Solderon™BP TS 6000锡银镀液已被证明是电解和热稳定。提供> 100 Ah/L的电解浴寿命和≥6个月的锅寿命,它兼容在线计量过程,具有优越的易用性。


过程多功能性

图1
Solderon™BP TS 6000锡银宽工艺的例子
窗口在一系列应用程序,过程条件和电镀速率范围内。
光刻胶的兼容性
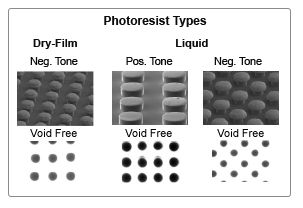
图2。
Solderon™BP TS 6000锡银显示一致,
通过干膜和液体光致抗蚀剂的无空隙性能。
厚度均匀性:在模具(Wid)内和晶片内(WiW)内

- WID均匀性在6-10 ASD <5%
- Wiw均匀性<10%从6-10 ASD
图3。
Solderon™BP TS 6000锡银的WID和WIW均匀性
证明其适合大批量生产。

形态学,排尿性能
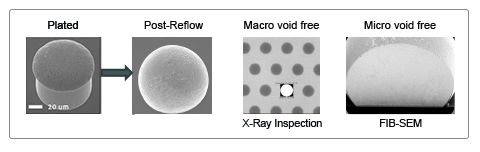
图4。
Solderon™BP TS 6000锡银提供改善的均匀性和更平滑的表面
除了与杜邦一起使用时,除了平滑,无空隙界面之外
和其他领先的铜(Cu)支柱配方。
金属互化物
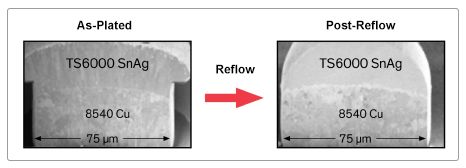
图5。
在Cu Parkar封盖应用中,Solderon™BP TS 6000锡银形式
回流后光滑、无微空隙的界面。